ELECTRONICS
断面FIB解析
FIBを使用することによりナノオーダーでの観察が可能です。
断面加工観察
イオンビームによる精密加工で、所望箇所の断面を観察します。
また、イオンビームによる結晶方位に依存したコントラストで金属結晶粒の観察もできます。
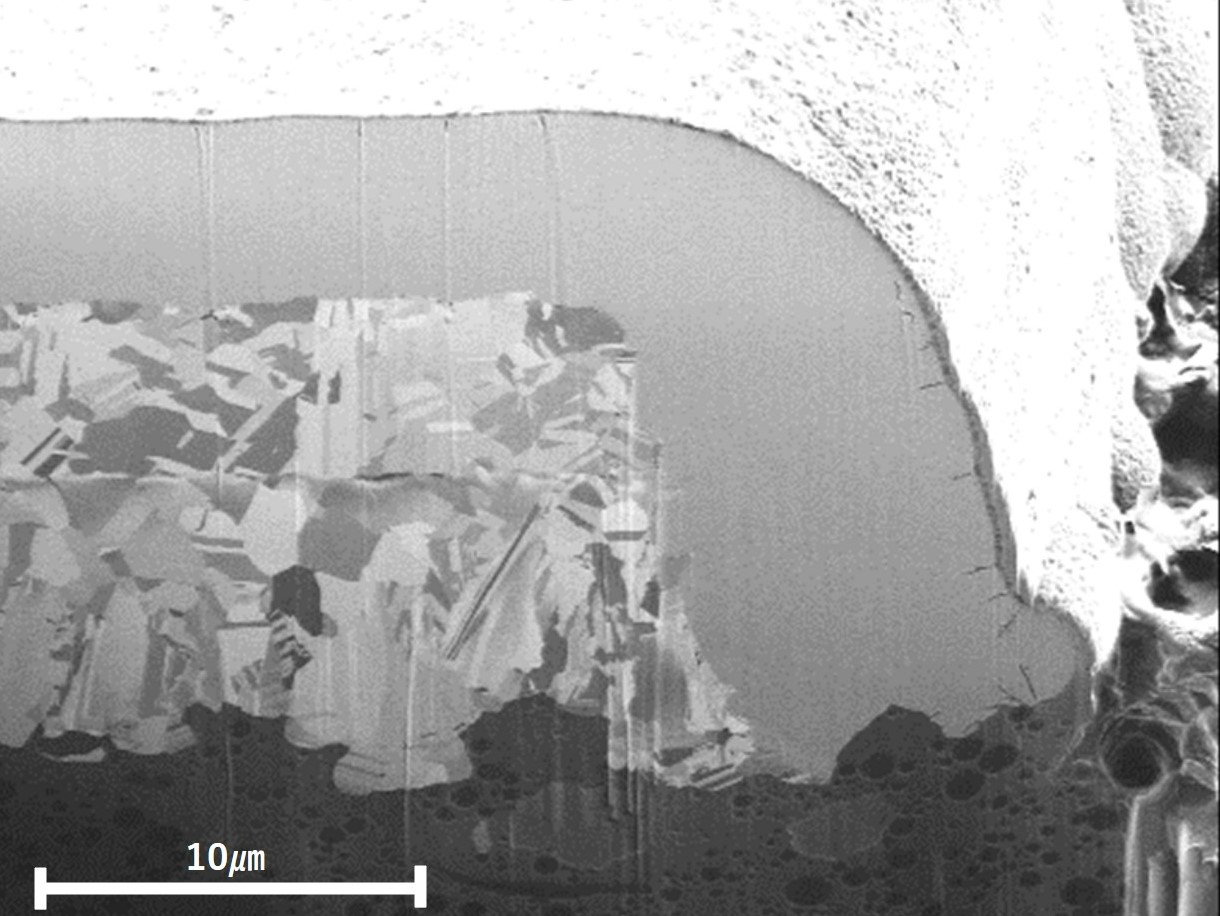
透過電子顕微鏡用試料作成
マイクロサンプリング法により試料から25um程度のマイクロサンプルの抽出が可能で、特定箇所の厚みを100nm程度に薄膜することにより透過電子顕微鏡での透過観察にも対応しています。
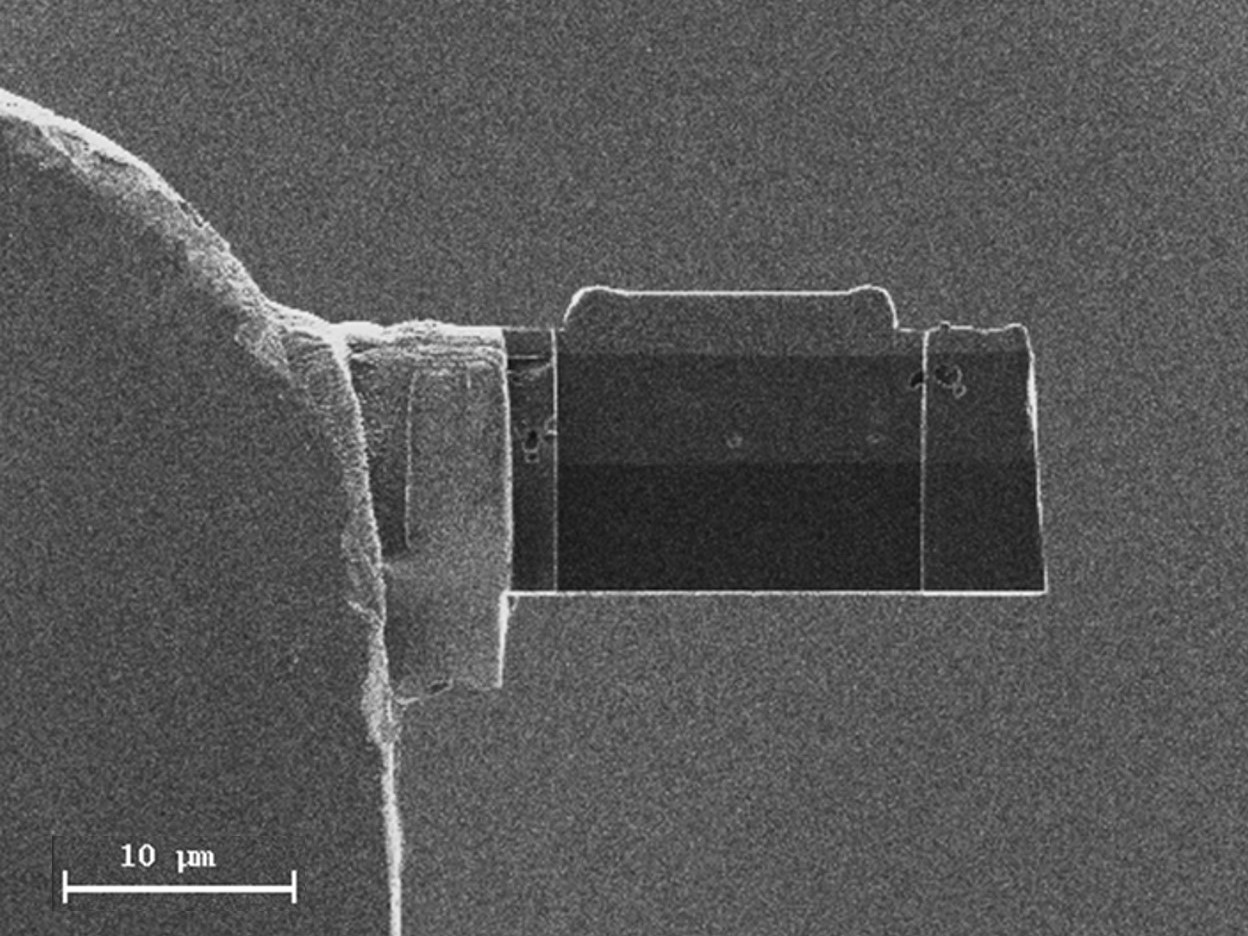
CMOS構造の観察
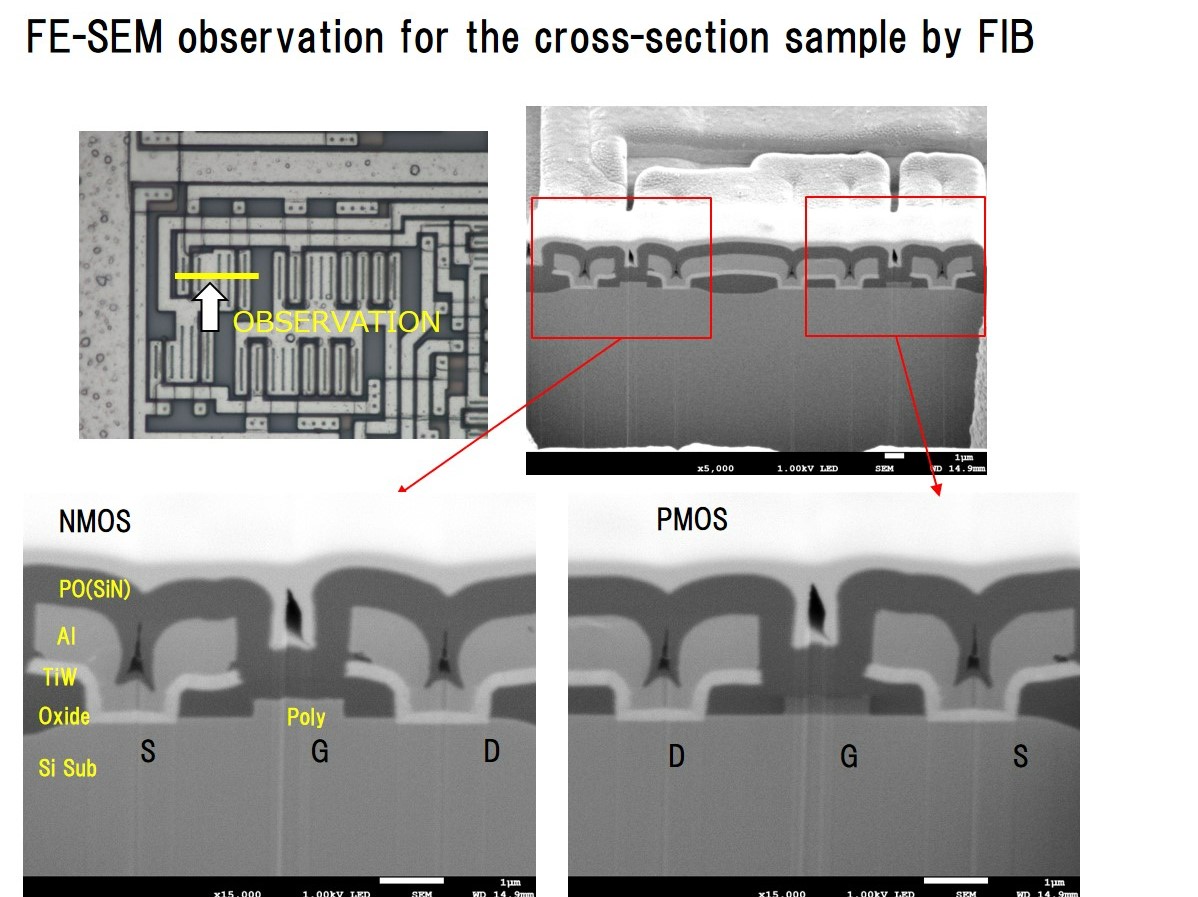
電子ビームで観察しながらFIBで加工できる『Dual Beam FIB』を導入しております。
FIB加工した断面をそのままSEMで観察できるようにした装置で、断続的に加工と観察を繰り返して得られる数百枚のSEM像を専用ソフトウェアで立体的に再構築し、3次元的な構造解析が可能です。
FIB_NX-5000

FIB_Helios-5-dualbeam
§ 2025年5月導入
低加速電圧による高品質な試料作成
TEM試料作成の完全自動化

| 型式 | FB-2100 | NX5000 | Helios 5 HX |
|---|---|---|---|
| メーカー | 日立 | 日立 | Thermo Fisher Scientific |
| FIB加速電圧 | 2~40KV | 0.5~30KV | 0.5~30KV |
| SIM分解能 | 6nm | 4nm | 4nm |
| 試料サイズ | 20x20mm | Φ150mm | Φ70mm |
| SEM(電子ビーム) | × | 〇 | 〇 |
| SEM分解能 | × | 0.7nm | 0.6nm |
| TEM/STEM試料作成 | 〇 | 〇 | 〇 |
| 特記 | 加速40KV | ・トリプルビーム ・自動加工 (マイクロサンプリング無) | 自動加工 (マイクロサンプリング有) |

