ELECTRONICS
STEM観察(走査透過顕微鏡)
STEM観察では、CMOS製品のゲート酸化物などの非常に薄い層まで観察することが可能です。
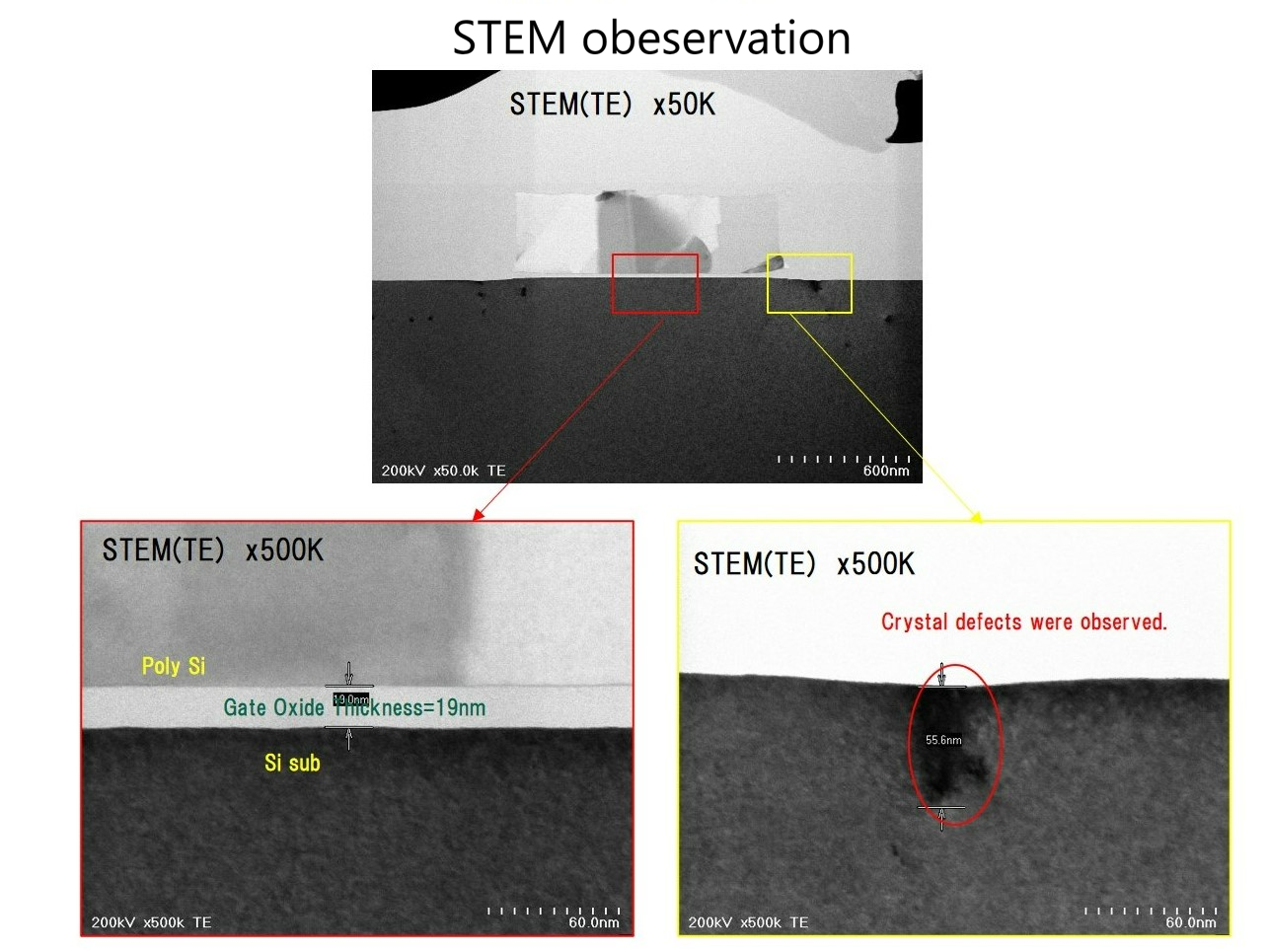
先端プロセス製品(Low-K酸化膜の縮体なし)の断面観察が可能なSTEMを導入しております。
STEM(走査透過顕微鏡)

TEM(透過型電子顕微鏡)
§ 2025年6月導入
・自動観察(レシピ使用)
・高分解能
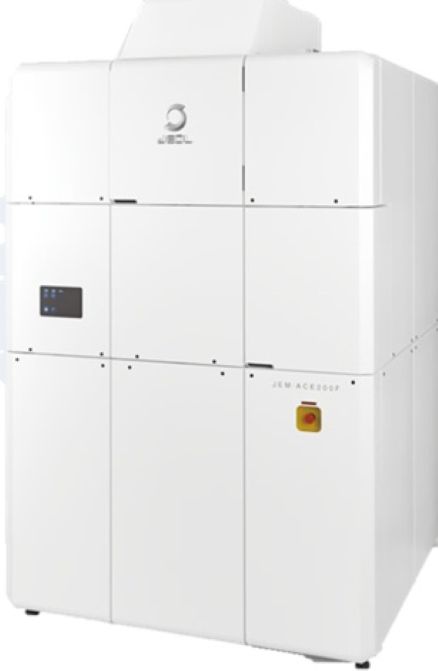
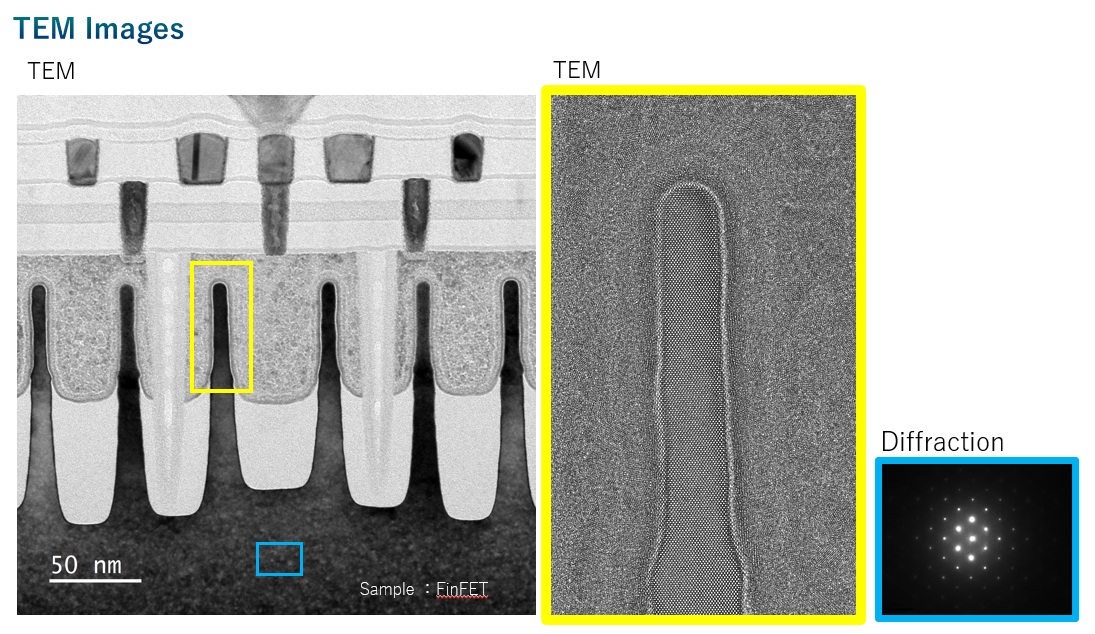
左側:配線や層間膜を含むFinFETの断面構造
右側:FinFETのSi基板の格子像が明瞭に観察されています。
また、絶縁膜であるゲートシリコン酸化膜も明瞭に観察
| STEM 走査透過電子顕微鏡 |
TEM 透過型電子顕微鏡 |
|
|---|---|---|
| 型式 | HD-2700 | JEM-ACE200F |
| メーカー | 日立 | JEOL |
| 加速電圧 | 80,120,200KV | 80,200KV |
| EDX | B~U 検出器(オックスフォード) |
B~U 検出器(JEOL) |
| 分解能 | 0.204nm | 0.102nm |
| 最高倍率 | 8M | STEM 150M TEM 30M |
| 最大解像度 | 2560×1920 | 4096×4096 |

